Fehlerdiagnostik und nanoskopische Untersuchungen an Dünnschicht-Solarmodulen erfordern extrem hochauflösende Analytik. Für die Prozess- und Materialbewertung in der Dünnschicht-Photovoltaik (CdTe, CIGS, Si, OPV) werden elektrische, optische und mikrostruktur-analytische Verfahren kontinuierlich weiterentwickelt. Die Zuverlässigkeit von Dünnschicht-Solarmodulen ermitteln wir anhand ortsaufgelöster Ertrags-/Verlustanalysen und Ursachenforschung an Ausfällen in Freifeld- und Laborinstallationen. Spezielle Teststrukturen entwerfen und fertigen wir mittels Laserstrukturierung und Beschichtungstechnik.
Partner aus der PV-Industrie, Anlagenbetreiber und Equipmenthersteller definieren die F&E-Aufgabenstellungen. Mit elektro-optischen Lokalisierungs- und Präparationstechniken und materialwissenschaftlicher Analytik lassen sich Defektursachen in kürzester Zeit bis in atomare Dimensionen aufklären. Auf der Basis eines grundlegendens Verständnisses der Prozessbedingungen und der resultierenden elektrischen Materialeigenschaften entwickelt das Team Dünnschichtcharakterisierung Vorschläge zur »in line«-Diagnostik.
Dünnschicht-PV: Mikroanalytik und Laserstrukturierung
Leistungen
- Defektdiagnostik in der Dünnschicht-PV: Lokalisierung, Zielpräparation und Mikrostrukturanalyse
- Elementanalytik im Schichtstapel: Quantitative Tiefenprofilanalysen mit TOFSIMS, XPS, TEM
- Laserstrukturierung und Auftragsbeschichtung (TCOs, Rückkontakte)
- Elektrische Mikrocharakterisierung
- Optische Simulation/Charakterisierung
Beispiele
Defektdiagnostik
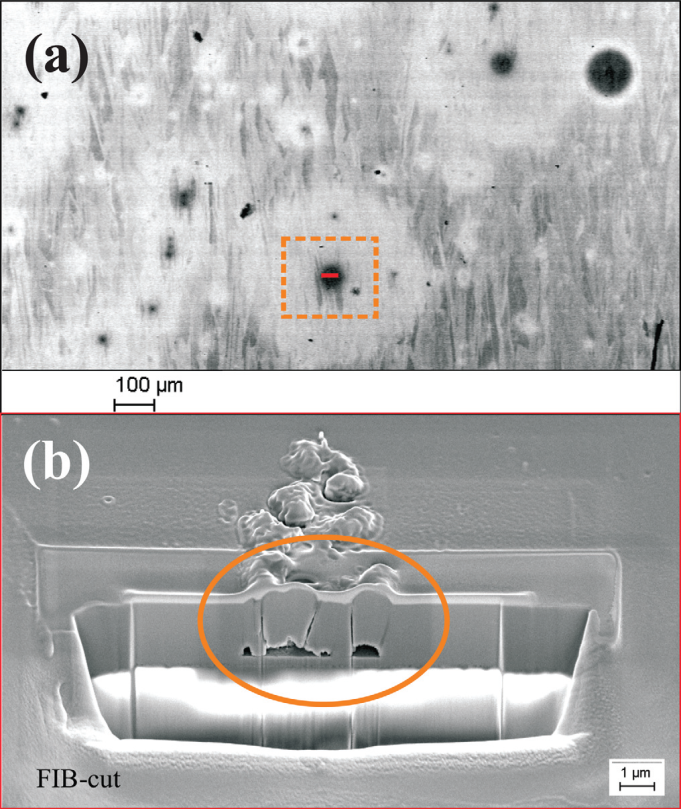
Defektdiagnostik in kristallinen Si-Dünnschichten
Defekte und Verunreinigungen in Dünnschicht-Solarzellen werden mit elektrooptischen Verfahren und REM/EBIC (a) lokalisiert. Durch Zielpräparationsverfahren lassen sich vergrabene Defekte im Schichtaufbau auffinden (b), die Rückschlüsse auf Fehler im Prozess erlauben. Weiterführende elementanalytische Verfahren wie ToF-SIMS, XPS, TEM/EDX helfen bei der Klassifizierung von verschiedenen Defekttypen.
Laser-Strukturierung
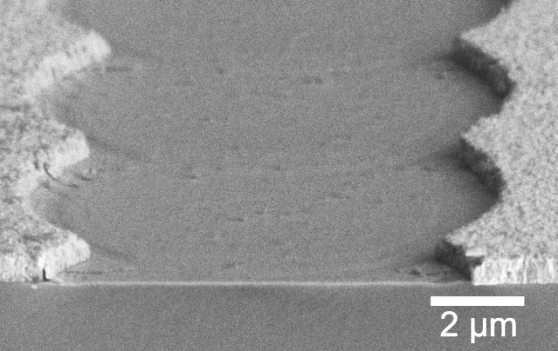
Laser-Strukturierung in der Dünnschicht-PV
Bei der Prozessierung aller Dünnschicht-PV Konzepte (CIGS, CdTe, a-Si/µc-Si, etc.) ist die Qualität und Größe der Laserstrukturen zur monolithischen Verschaltung des Schichtstapels von großer Bedeutung für die spätere Modulleistung. Durch die Anpassung der Laserparameter je nach Schichtsystem und Strukturierungsschritt kann die Abtragsqualität optimiert werden. Im Hinblick auf Effizienzeinbußen und Zuverlässigkeit gilt dabei der Vermeidung von Wärmeeinflusszonen sowie Schmelz- und Materialresten infolge des Laserabtragsprozess besondere Beachtung. Dafür kommen Kurzpuls(ns)- und Ultrakurzpulslaser(fs) mit unterschiedlichen Wellenlängen zum Einsatz. Anschließende Mikrostrukturanalysen (Raman, Laserscanning-Mikroskopie etc.) sowie begleitende optisch-thermische Simulationen dienen der Prozesskontrolle und dem Verständnis des Abtragsverhaltens.
TCO-Schichtsysteme
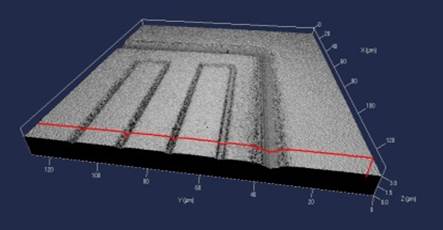
Widerstandsmessung an TCO-Schichtsystemen
In der Prozess- und Qualitätskontrolle der Dünnschichtphotovoltaik wird ein einfaches Messverfahren benötigt, das sich für die Bestimmung des spezifischen Widerstands von dünnen Schichten, die sich auf Schichten mit höherer Leitfähigkeit befinden, eignet. Im Rahmen eines Forschungsprojekts entwickelten Wissenschaftler des Fraunhofer CSP ein abgewandeltes Transferlängen-Messverfahren (TLM). Die dafür notwendige mikroskopische Prüfstruktur wird mittels Ionenstrahlätzen oder mittels fs-Laserablation in den Schichtstapel eingebracht. Mit der anschließenden TLM-Messung auf Mikrometerskala lässt sich z.B. der spezifische Widerstand einer TCO-Pufferschicht direkt im Schichtstapel bestimmen.
Anti-Soiling-Bewertung
Anti-Soiling-Bewertung von Glasbeschichtungen
In Regionen mit hoher Staubbelastung in der Luft (z.B. Wüsten, Städte) kommt es durch Ablagerung des Staubs auf den Glasoberflächen der PV-Module zu signifikanten Ertragsverlusten. Um den Reinigungsaufwand zu minimieren, können u.a. Anti-Soiling-Schichten eingesetzt werden. Für das Verständnis und die Überprüfung der Funktion dieser staubabweisenden Schichten ist eine mikrostrukturelle Charakterisierung hilfreich. So finden z.B. unter realen Wüstenbedingungen Zementationsprozesse statt, bei welchen Staubpartikel regelrecht an das Glas „angebacken“ werden. Die Simulierung solcher Verschmutzungsprozesse im Labor realisieren wir mit Hilfe eines eigens hierfür entwickelten Teststandes.
Weiterführende Informationen zum Thema Anti-Soiling und Abrasion in der Photovoltaik
Zielpräparation und Mikrostrukturanalyse
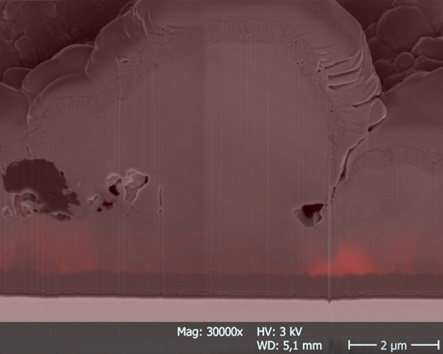
Zielpräparation und Mikrostrukturanalyse
Bei der Analyse von Dünnschichtsolarzellen z.B. aus CIGS oder CdTe kommen Methoden der Defektdiagnostik zum Einsatz. Durch die Zielpräparation mittels Focussed Ion Beam (FIB) können gezielt Defektbereiche präpariert und untersucht werden. Die Kombination der strukturellen Analyse mit elektrischen Verfahren (FIB-EBIC) ermöglicht eine direkte Zuordnung elektrischer und struktureller Eigenschaften und somit die Aufklärung von Defektursachen auf mikrostruktureller Skala.
 Fraunhofer-Center für Silizium-Photovoltaik CSP
Fraunhofer-Center für Silizium-Photovoltaik CSP

